
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Hvad er LPCVD-processerne?
Lavtrykskemisk dampaflejring (LPCVD) processer er CVD-teknikker, der afsætter tyndfilmsmaterialer på waferoverflader under lavtryksmiljøer. LPCVD-processer er meget udbredt i materialeaflejringsteknologier til halvlederfremstilling, optoelektronik og tyndfilmsolceller.
Reaktionsprocesserne af LPCVD udføres typisk i et lavtryksreaktionskammer, normalt ved et tryk på 1-10 Torr. Efter at waferen er opvarmet til det temperaturområde, der er egnet til aflejringsreaktionen, indføres gasformige forstadier i reaktionskammeret til afsætning. De reaktive gasser diffunderer til waferoverfladen og gennemgår derefter kemiske reaktioner på waferoverfladen ved høje temperaturforhold for at danne faste aflejringer (tynde film).
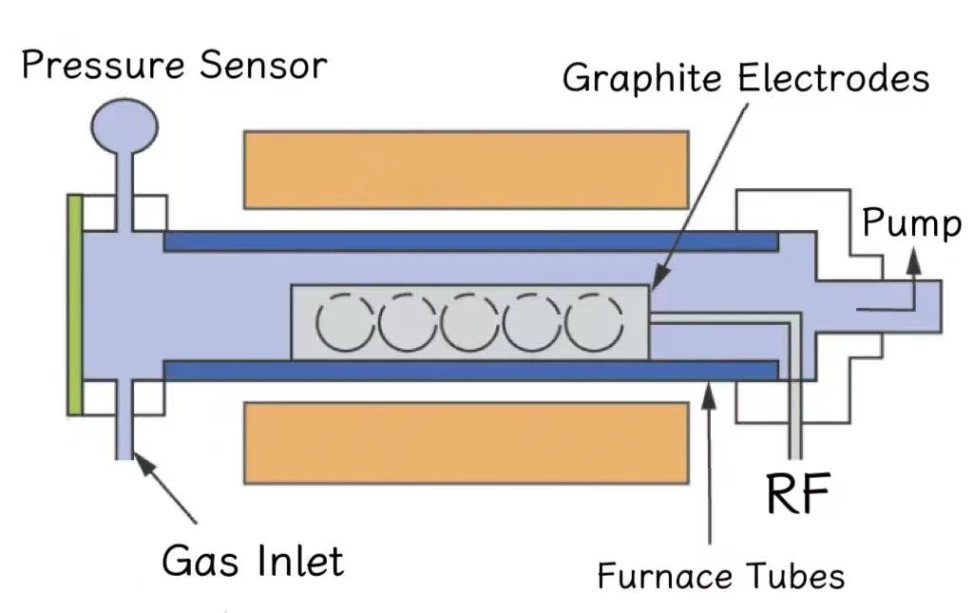
Fordele ved LPCVD-processer
1. Højkvalitets tyndfilmaflejringskvalitet
Transporthastigheden af reaktantgasserne fremskyndes, når trykket er lavt, fordi gassernes diffusionskoefficient stiger. Der kan således skabes en mere ensartet fordeling af gasmolekyler i hele reaktionskammeret, hvilket sikrer, at gasmolekyler reagerer fuldt ud med waferoverfladen og væsentligt reducerer hulrum eller tykkelsesforskelle forårsaget af ufuldstændige reaktioner.
2. Fremragende denne film trin dækning
Den forbedrede gasdiffusionsevne under lavt tryk gør det muligt at trænge dybt ind i komplekse strukturer. Dette sikrer, at den reaktive gas er i fuld kontakt med trinene og renderne på waferoverfladen, hvilket opnår ensartet aflejring af tynde film. Som et resultat er tyndfilmaflejring på indviklede strukturer en god anvendelse for LPCVD-metoden.
3.Stærk operationel kontrollerbarhed
LPCVD-processer udviser stærk kontrollerbarhed under faktisk drift. Sammensætningen, strukturen og tykkelsen af den tynde film kan kontrolleres præcist ved at justere reaktantgasparametre som type, strømningshastighed, temperatur og tryk. LPCVD-udstyr har relativt lave investerings- og driftsomkostninger sammenlignet med andre deponeringsteknologier, hvilket gør det velegnet til storstilet industriel produktion. Og konsistensen i processer under masseproduktion kan effektivt sikres med automatiserede systemer, der overvåger og justerer i realtid.
Ulemper ved LPCVD-processer
Da LPCVD-processer typisk udføres ved høje temperaturer, hvilket begrænser anvendelsen af nogle temperaturfølsomme materialer, skal wafers, der skal behandles af LPCVD, være varmebestandige. Under LPCVD-processer kan de uønskede problemer opstå, såsom wafer wrap-around aflejring (tynde film aflejret i ikke-målområder af waferen) og vanskeligheder med in-situ doping, som kræver efterfølgende behandling for at løses. Derudover kan den lave koncentration af dampprækursorer under lavtryksbetingelser føre til en lavere tyndfilmaflejringshastighed, hvilket resulterer i ineffektiv produktionseffektivitet.
Semicorex tilbyder høj kvalitetSiC fovnrørs, SiC cantilever pagajerogSiC wafer bådetil LPCVD-processer. Hvis du har spørgsmål eller brug for yderligere detaljer, så tøv ikke med at kontakte os.
Kontakt telefon # +86-13567891907
E-mail: sales@semicorex.com





